パッケージは「黒子」から「主役」へ
半導体の進化は、これまでトランジスタの微細化によって支えられてきました。
しかし現在では、微細化の限界が見え始め、従来の方法だけでは十分な性能向上が難しくなっています。
その中で注目されているのが、チップを包み込む「パッケージ技術」です。
パッケージは単にチップを保護するだけではなく、複数のチップを組み合わせ、電気的に効率よく接続し、高い性能を引き出す仕組みとして進化しています。
本記事では、最新のパッケージ技術としてよく耳にする CoWoS、CoPoS、CoWoP について、理解しやすく解説します。
従来のパッケージとその限界
従来の半導体パッケージは、ひとつのチップを基板に載せてワイヤで外部と接続する方式が中心でした。
小型化が進むにつれてフリップチップ(チップを裏返してはんだで接続する方式)が普及しましたが、それでも「1つのチップにすべての機能を詰め込む」スタイルには限界があります。
大規模化する回路は歩留まりを悪化させ、製造コストも跳ね上がります。
また、AIやHPC(ハイパフォーマンスコンピューティング)のような用途では、数百GB/s以上のデータ帯域が必要になり、従来のパッケージ構造では対応しきれません。
このような課題を解決するために、複数のチップを組み合わせて「ひとつの大きなシステム」として動作させるパッケージ技術が登場しました。
その代表例が CoWoS、CoPoS、CoWoP です。
CoWoSとは?

CoWoS(Chip on Wafer on Substrate) は、TSMCが開発した技術で、大きなシリコンインターポーザ(中間基板)の上に複数のチップを並べて実装し、それを基板に載せる方式です。
ロジックチップとHBM(高帯域幅メモリ)を近接して配置できるため、非常に広い帯域でデータをやり取りでき、AIやスーパーコンピュータなどの高性能分野で採用が進んでいます。
NVIDIAのGPUやAMDのアクセラレータがその代表例です。
- インターポーザを介して複数チップを高速接続
- 高性能HPCやAI向けに最適
- 高コスト・大規模用途向け
CoPoSとは?
CoPoS(Chip on Package on Substrate) は、基板の上に配置したパッケージのさらに上にチップを積層する方式です。
名前の通り、パッケージの上にチップを直接載せるのが特徴です。
この方式は、スマートフォンやタブレットなどのモバイル機器で特に有効です。
限られたスペースに多くの機能を詰め込む必要があり、コスト面の制約も厳しいため、コンパクトかつ低コストで実現できるCoPoSが適しています。
- パッケージの上にチップを直接積層
- 小型・低コストが求められる民生機器に有効
- スマホやIoTデバイス向け
CoWoPとは?
CoWoP(Chip on Wafer on Package) は、CoWoSの発展形といえる技術です。
大きなインターポーザやウェハ状の中間層を使い、その上に複数チップを載せてから基板に接続します。
CoWoSと似ていますが、さらに大規模かつ柔軟に複数チップを組み合わせられる点が特徴です。AIサーバやデータセンターのように、より広い帯域と大規模な計算能力が必要な分野で注目されています。
- 大規模で柔軟なチップ統合が可能
- CoWoSよりさらにスケーラブル
- 次世代のHPC/AI向けに期待
なぜ3種類が存在するのか?
ここで気になるのが「なぜCoWoS、CoPoS、CoWoPと複数方式があるのか」という点です。
これは直線的な進化ではなく、それぞれの用途に合わせた最適な方法として存在します。
- CoWoSは「高性能を最優先する分野」
- CoPoSは「小型化と低コストを重視する民生機器」
- CoWoPは「大規模・高柔軟性が求められるデータセンター」
つまり、どれが「次世代」でどれが「旧世代」という関係はなく、ニーズごとに最適な技術が存在しているのです。
未来のロードマップ
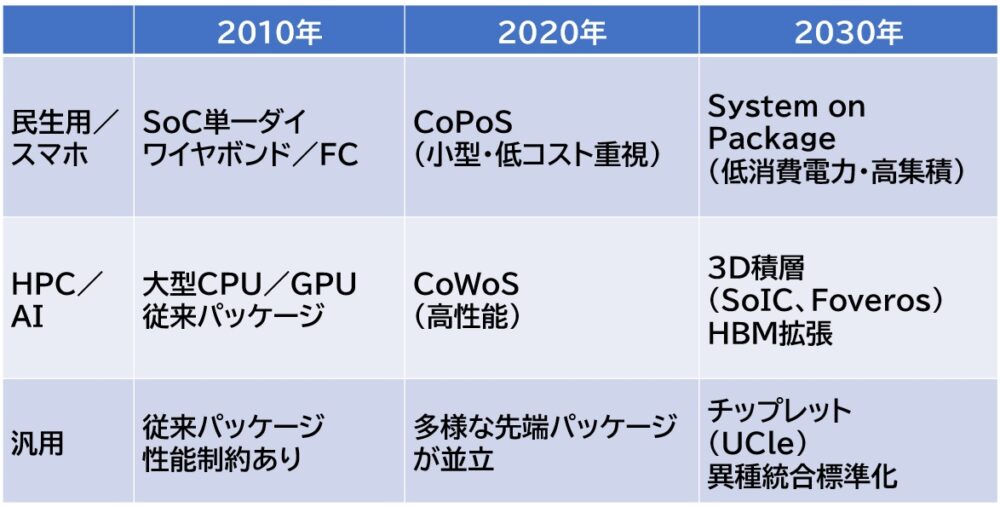
これらの技術は、今後さらに進化していくでしょう。
以下は、主な代表例の方向性です。
- 3D積層技術(TSMCのSoIC、IntelのFoverosなど)
→ チップを縦方向に積み重ねて、さらなる高密度・高性能化を実現 - チップレットと標準化(UCIe)
→ 異なるメーカーのチップを組み合わせ、システムを自由に構築可能に - System on Package
→ ひとつのパッケージ内に異種機能を集約し、小型で高性能な「小さなシステム」を実現
これらは、今のCoWoS、CoPoS、CoWoPをベースに発展していくと考えられています。
まとめ
パッケージ技術は、これからの半導体業界でますます重要な位置を占ねていくでしょう。
技術そのものだけでなく、「どの市場で、なぜその方式が選ばれるのか」 という背景を理解しておくことは重要です。
- 高性能重視ならCoWoSやCoWoP
- 小型・低コスト重視ならCoPoS
- そして未来はチップレットと3D積層へ
こうした流れを理解しておくことで、自分が携わるプロジェクトやキャリアの方向性を考える大きなヒントにもなるでしょう。



