半導体の性能は、日々「より小さく・より高性能」へと進化しています。
その進化を支えている中心技術の一つが、フォトリソグラフィとフォトレジストです。
しかし、この分野は専門用語が多く、初心者にとっては「どこが難しいのかすら分からない」と感じることも少なくありません。
本コラムでは、EUVレジストとは何か、なぜHigh-NA対応が重要なのか、そして市場としてどれほど大きな意味を持つのかを解説します。
フォトレジストとは

フォトレジストとは、光に反応して化学的に変化する材料で、半導体回路を描くために使われます。
よく「光で描くインク」に例えられます。
半導体回路ができる基本的な流れは次のとおりです。
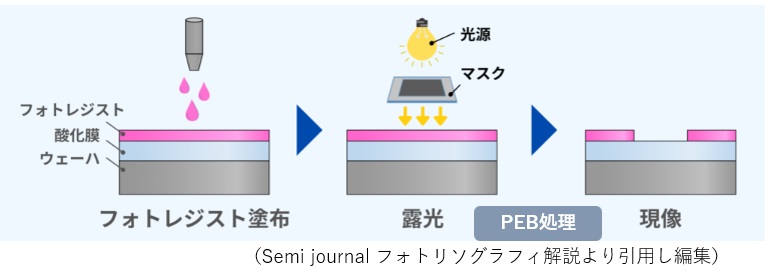
- コーティング(Coating)工程 シリコンウエハの表面に、光に反応する特殊な薬品「フォトレジスト(感光剤)」を薄く均一に塗布します。
- 露光(Exposure)工程 回路パターンが描かれた「マスク(レチクル)」に光を当て、レンズを通してウエハ上にパターンを転写します。この瞬間、光が当たった部分のレジストに化学変化の種が作られます。
- PEB(Post-Exposure Bake)工程 露光直後のウエハを加熱します。露光で生じた化学反応を熱によって促進・拡散させ、パターンの境界線をはっきりさせます。(特に最近の微細なプロセスでは、この工程がパターンの仕上がりを左右する非常に重要な鍵となります)
- 現像(Development)工程 専用の現像液でレジストを洗浄します。光が当たった部分(または当たらなかった部分)が溶け出し、ウエハ上に設計通りの細い回路パターンが姿を現します。
つまり、
(光を当てる) → (化学反応) → (形が残る)
という仕組みで、ナノメートル(nm)サイズの微細な回路が作られていきます。
参考:Semi journal 半導体のフォトリソグラフィとは?工程フローと原理
EUVレジストとは?
EUVとは Extreme Ultra Violet(極端紫外線) の略で、波長13.5nmという非常に短い光を使います。
なぜ波長が短いと有利なのか?
光で描ける線の細さは、基本的に波長が短いほど細かく描けるという性質があります。
以下は、なぜ光の波長が短いと、細密な回路が描けるのかを説明します。
1. 光は「回折(かいせつ)」して広がる

光は真っ直ぐ進むイメージがありますが、実はピンホールのような狭い隙間を通ると、出口で外側にふわっと広がってしまう性質があります。
これを「回折」と呼びます。
カメラのピントがぼやけるように、光が広がってしまうと、細い線をシャープに描くことができません。
2. 「波のサイズ」が広がりの大きさを決める
ここで重要になるのが波長です。
- 波長が長い光: 回折の影響を強く受け、大きく広がります(ぼやけやすい)。
- 波長が短い光: 回折の影響が小さく、あまり広がらずに進みます(シャープに描ける)。
海の大きな波は防波堤の裏側に回り込みますが、小さなさざ波はそのまま通り抜けていくイメージです。波長が短いほど、光を「細いビーム」のように扱えるため、精密な加工が可能になります。
3. 結論:より細かく、より高性能に
現在の最先端チップでは、EUV光という非常に波長の短い光が使われています。
波長を極限まで短くすることで、数ナノメートルという原子レベルに近い細い回路を焼き付けることができるのです。
光が波である以上、どうしても「回折によるボヤけ」が発生します。
このボヤけを最小限に抑え、シャープな線を引くための最も確実な方法が「波長を短くすること」なのです。
【 参考:i線〜EUV線までの露光光源一覧表】
| 光の種類 | 波長 | 光源の種類 | 発光方法 | 主な用途 |
| g線 | 436nm | 水銀ランプ(Hgランプ) | ガラス管内の水銀に電圧をかけて放電させ、プラズマ状態にする | 旧世代の微細加工、MEMS |
| h線 | 405nm | |||
| i線 | 365nm | 350nm〜250nm世代、レジスト評価、MEMS | ||
| KrF | 248nm | KrFエキシマレーザー | Kr(クリプトン)とF(フッ素)を混ぜたガスに高電圧をかける | 130nm〜90nm世代 |
| ArFドライ | 193nm | ArFエキシマレーザー | Ar(アルゴン)とF(フッ素)の混合ガスを高電圧パルス放電(放電励起)により励起 | 65nm〜45nm世代 |
| ArF液浸 | 193nm(液浸) | ArFエキシマレーザー+液浸光学系 | 発光は ArFエキシマレーザーと同じで、「レンズとウエハの間に水を入れる」 | 40nm〜10nm世代(多重パターニング) |
| EUV | 13.5nm | レーザー生成プラズマ(LPP)光源 | ・1.スズ(Sn)の微小液滴を空中に飛ばす ・2.高出力CO₂レーザーを液滴に照射 ・3.スズが一瞬でプラズマ化 ・4.プラズマが冷える瞬間に 13.5nmのEUV光 を放出 ・5.その光を多層膜ミラーで反射しながら露光装置へ導く | 7nm以下の最先端ノード |
EUVレジストは、この13.5nmの光に反応するように特別に設計されたレジストです。
従来のレジストではほとんど反応しないため、材料設計そのものが大きく異なります。
High-NA EUVとは何か
NA(開口数)とは?
NA(Numerical Aperture:開口数)は、レンズがどれだけ光を集められるかを示す指標です。
カメラに例えると、
- NAが小さい → ピントは合うが細部がぼやける
- NAが大きい → より細かい模様までくっきり写る
EUV露光装置の進化は次のとおりです。
| 世代 | NA |
| 現行EUV | 0.33 |
| High-NA EUV | 0.55 |
High-NA EUVでは、これまで以上に微細な回路を描けるようになります。
High-NA時代に求められるレジスト性能
High-NAになると、描く線はさらに細くなり、レジストの性能限界がより厳しく問われます。
| 性能 | 効果 | なぜ重要か |
| 高解像度 | 細い線を正確に描ける | 微細化の限界に直結 |
| 低LWR | 線のガタつきが少ない | 電気特性が安定する |
| 高感度 | 少ない光で反応する | EUV光は非常に弱い |
※LWRは Line Width Roughness(ライン幅ラフネス) の略です。半導体の製造プロセスにおいて、形成された回路パターンの「線の太さ」が場所によって不均一になってしまう現象のことです。
大きな課題:トレードオフ
- 感度を上げる → 線がぼやけやすい
- 解像度を上げる → 感度が下がる
- LWRを下げると → 感度や解像度に影響
この3つは 同時に良くすることが非常に難しい という関係にあります。
これを、開発者の間では「三すくみ(トリレンマ)」と呼んでいます。
この 「三すくみ問題」 をどう克服するかが、EUVレジスト開発の最大の難所です。
EUVレジストの最新技術トレンド

ドライレジスト(Dry Resist)
ドライレジストは、Lam Research が中心となって開発し、すでに先端DRAM向けに量産導入が始まっている新しいEUVレジスト技術です。
従来のように液体レジストを塗布する方式ではなく、プラズマ反応を利用してレジスト膜を直接形成する点が大きな特徴です。
この方式により、次のようなメリットが得られます。
- 液体レジストを塗布せずに、プラズマ反応による膜形成を行う
- 現像工程が簡略化され、工程数の削減や欠陥低減につながる
- 材料使用量が大幅に少なく、環境負荷の低減にも寄与
これらの特長から、ドライレジストはEUVパターニングの課題(感度・LWR・欠陥)を同時に改善できる技術として評価されており、メモリ分野ではすでに量産ラインでの採用が進んでいます。
メタルオキサイドレジスト(MOR)
メタルオキサイドレジスト(MOR)は、ハフニウム(Hf)やジルコニウム(Zr)などの金属酸化物ナノ粒子をベースにした次世代レジスト材料です。
従来の有機系レジスト(CAR)は、有機ポリマー(高分子)をベースにしたレジスト材料ですが、MORは、CARとは全く異なる材料体系で、EUV光を効率よく吸収し、極めて高い解像度を実現できる点が特徴です。
■ MORの(メリット)
- EUV光の吸収率が非常に高い
有機系レジストよりもEUV光を効率よく吸収できるため、薄膜でも十分に反応し、高解像度を実現できます。 - 線が非常にシャープ(高解像度)
ナノ粒子が硬く安定しているため、エッジが崩れにくく、LWR(線幅のガタつき)が小さいという強みがあります。 - High-NA EUVとの相性が良い
High-NAでは膜厚を薄くする必要がありますが、MORは薄膜でも性能を維持できるため、次世代の本命候補とされています。
■ MORの課題(なぜ量産が難しいのか)
- 材料コストが高い
ハフニウム・ジルコニウムなどの金属原料が高価で、製造プロセスも複雑なため、材料コストがCARより大幅に高い傾向があります。 - 欠陥制御が難しい
ナノ粒子が凝集(ダマになる)と欠陥の原因となり、量産レベルの欠陥密度に到達するのが難しいとされています。 - 既存プロセスとの互換性が低い
エッチング特性や現像挙動がCARと異なるため、既存ラインにそのまま置き換えることが難しいという課題があります。
■ 現状:High-NA向けの本命だが、量産はまだ
- imecやJSR(Inpria)を中心に研究が進む
- High-NA EUVでの性能は非常に高いと評価
- しかし、量産導入はまだ実現していない
- 現在は 研究開発〜試作評価段階
つまり、技術ポテンシャルは極めて高いが、量産化にはもう一段のブレイクスルーが必要という位置づけです。
化学増幅型レジスト(CAR)の進化
従来方式のレジストですが、改良が続いています。
- 酸拡散を抑制しLWRを改善
- 分子設計をより精密に
- 既存インフラを活かせるため量産性が高い
EUV時代でも依然として重要な選択肢です。
CAR・MOR・ドライレジストの比較表
| 項目 | CAR(化学増幅型レジスト) | MOR(メタルオキサイドレジスト) | ドライレジスト(Dry Resist) |
| 材料の仕組み | ポリマー+PAG(酸発生剤)で化学反応を増幅 | 金属酸化物ナノ粒子(Hf、Zrなど) | プラズマ反応でレジスト膜を直接堆積 |
| 光の吸収性 | 中程度(EUVでは吸収が弱い) | 非常に高い(EUV吸収に優れる) | 高い(薄膜でも十分吸収) |
| 解像度 | 改良により向上中 | 非常に高い(線がシャープ) | 高い(EUV向けに有利) |
| LWR(線のガタつき) | 酸拡散抑制で改善中 | 低い(粒子が硬く安定) | 低い(プラズマ堆積で均一) |
| 感度(少ない光で反応) | 中程度(改良で向上) | 高い | 高い |
| 欠陥(Defectivity) | 量産レベルで安定 | 課題が大きい(粒子凝集など) | 低欠陥(評価で良好) |
| 膜厚制御 | スピン塗布で制御 | 均一化が難しい場合あり | 非常に精密(プラズマ堆積) |
| 工程互換性 | 既存ラインと完全互換 | 一部工程で調整が必要 | 新規プロセスだが導入実績あり |
| 材料コスト | 低〜中 | 高い | 中 |
| 量産状況(2025) | EUV量産の主力として広く使用中 | 量産導入なし(試作・研究段階) | DRAMで量産導入開始、ロジックは評価中 |
| High-NA適性 | 改良次第で対応可能 | 本命候補とされる | 高い適性(imec評価済み) |
| 総合評価 | 現行EUVの主力。成熟技術で安定 | 高性能だが量産課題が大きい | 次世代の有力候補として台頭 |
技術別提供企業の状況
| 技術分類 | 提供企業 | 備考 |
| 化学増幅型レジスト(CAR) | 東京応化、JSR、信越化学、富士フイルム、住友化学、DuPont、Dongjin Semichem | EUV量産ラインの主力。各社が改良を継続中 |
| メタルオキサイドレジスト(MOR) | JSR(Inpria) | 高性能だが量産導入は未定。研究・評価段階 |
| ドライレジスト(Dry Resist) | Lam Research(米国) | 材料はLamが提供。DRAMで量産導入開始 |
フォトレジスト市場規模(世界・日本)

半導体製造に不可欠なフォトレジスト市場は、現在 約80〜100億ドル(約1兆円規模) とされ、今後も堅調な成長が見込まれています。
この中でも、最先端のEUV露光に用いられるレジストは市場全体ではまだ小規模ですが、最も高い成長率を持つ戦略分野として注目されています。
世界市場の構造と地域別の特徴
フォトレジスト市場は、地域ごとに明確な役割分担が形成されているのが特徴です。
● 日本:高性能レジストで世界トップ
日本は、EUV・ArF・KrFなどの先端レジスト分野で圧倒的な存在感を持っています。
● 台湾・韓国:大量生産の中心地
TSMC、Samsung、SK hynix などの大手ファウンドリ・メモリメーカーが集中しており、ArF・KrF・EUVレジストの大量需要が発生する地域です。
日本企業のレジストは、これらの量産工場に大量供給されています。
● 米国:先端研究とHigh-NA EUVの主導
米国は、IntelやLam Researchを中心に、High-NA EUV向けの次世代レジスト開発を主導しています。
特にLam Researchのドライレジスト技術は、すでにDRAMで量産導入が始まり、次世代EUV材料として存在感を高めています。
● 中国:国産化を国家戦略として推進
中国は、半導体材料の国産化を国家戦略として強力に推進していますが、EUVレジストに関しては依然として技術的ハードルが高く、日本企業への依存度が極めて高い状況が続いています。
日本市場の位置づけ
日本国内のフォトレジスト市場は 約2,000〜3,000億円規模 とされており、世界市場の中でも高い比率を占めています。
特にEUVレジストでは、以下の3社が世界トップシェアを占めています。
- 東京応化工業(TOK)
- JSR(Inpria含む)
- 信越化学工業
まとめ
EUVレジストは、半導体の微細化を支える最重要材料であり、High-NA EUVの登場によって、これまで以上に高度な性能が求められる時代に入りました。
感度・解像度・LWRという三すくみの課題を抱えながらも、CAR・MOR・ドライレジストといった多様な技術が進化し、次世代ノードに向けた競争が加速しています。
今後、High-NA EUVの本格導入が進むにつれ、レジスト材料の重要性はさらに高まり、技術革新と市場拡大の両面で大きな成長が期待されます。



